2010年刚到来,中道封装技术开始受到关注。不久之后,众多前沿技术被投入市场应用,封装质量有了明显进步。这种变化在芯片行业引起了不小的波动。
中道封装技术兴起
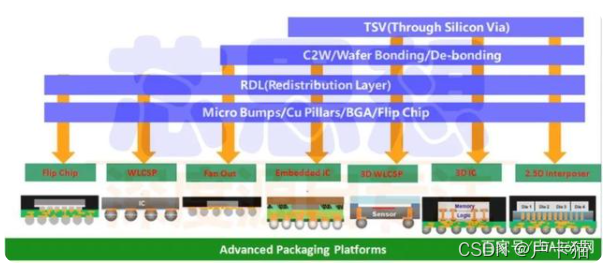
自2010年,中道封装技术应运而生。晶圆级封装与硅通孔技术等步入产业化。这些技术的问世具有深远影响,显著提升了芯片封装的效率。以WLP技术为例,它能在晶圆上直接完成封装,极大缩短了生产周期,提高了生产效率。
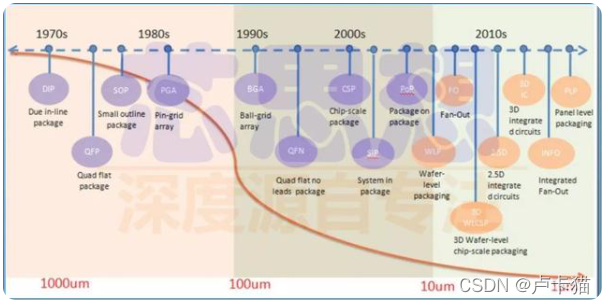
TSV技术在高端芯片封装领域表现出色。目前,众多CPU、GPU以及存储设备已开始采用这项技术。该技术突破了传统封装的限制,实现了芯片间的垂直连接,进而显著增强了芯片的性能。
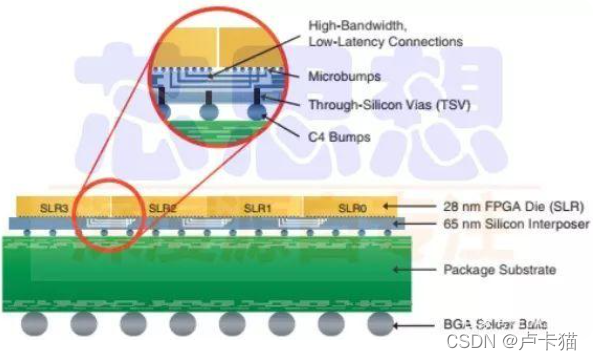
英特尔EMIB技术
2014年,英特尔发布了名为EMIB的一种新型2.5D芯片封装技术。该技术被认为是一种成本更低的2.5D封装替代品。与传统的2.5D封装不同,它不是使用硅中介层,而是在芯片边缘各自嵌入了一小片硅。这小块硅起到了连接的作用。

这种设计上的优化减少了费用,并且保证了出色的性能。在实际使用中,它提升了不同芯片间的交流速度,为电脑、手机等电子产品带来了更佳的芯片选择。
Foveros技术突破
Foveros有望实现技术上的重大突破。它能让芯片堆叠技术从传统的无源中间层和存储芯片,拓展至CPU、GPU以及人工智能处理器等高性能逻辑芯片。这种产品可拆分为更小的“芯片组合”。在这些组合中,I/O、SRAM和电源传输电路都集成在基础晶片上。而高性能逻辑的“芯片组合”则堆叠在上方。
芯片设计现在变得更为灵活多样,能够根据实际需求挑选恰当的芯片型号。它采用了3D堆栈的SiP封装技术,成功将不同种类的芯片整合在一起。从这个角度看,在摩尔定律的发展后期,SiP技术将发挥极其重要的作用。
扇出封装技术优势
在对比扇入封装技术时,扇出封装技术明显更胜一筹。它不对芯片的I/O数量和封装尺寸设限,同时也能满足多芯片系统封装的需求。这种技术能够将功能各异的芯片合并,构成一个完整的系统,从而显著减少所需空间。
这种封装技术有其独到之处,因而广泛用于各类产品中。比如在可穿戴设备领域,即便空间受限,它也能有效整合多种芯片,确保设备功能的实现。
InFO技术应用
苹果的A10、A11、A12芯片及存储器的PoP封装采用了InFO技术,这项技术革新激发了大家对Fan-Out技术的浓厚兴趣。此外,InFO技术还拓宽了WL-FO技术的应用范围,为芯片封装行业带来了新的发展活力。
台积电对InFO技术进行了优化升级,特别研发了InFO-oS方案,以适应高性能计算的需求。同时,还推出了InFO-MS方案,用于满足服务器和存储器的封装需求,以及InFO-AiP封装,针对5G通信天线。通过这些方案,各行业对芯片封装的多样化需求得到了有效满足。
封装技术未来展望
技术发展持续进步,预计在未来的某个时刻,中道封装技术将催生更多新发明。届时,我们或许能看到更加高效、更具有适应性的封装技术,它们将满足各类新型芯片的特定需求。
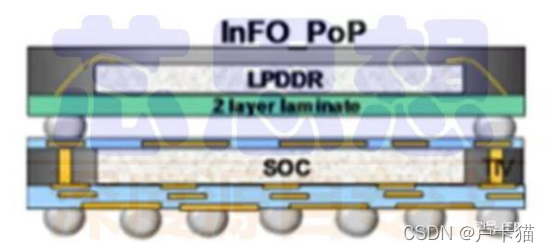
封装技术的提升极大地促进了电子产品的发展,使得我们的设备在性能上更为卓越且体积更小巧。展望未来,中道封装技术将为芯片产业带来哪些令人惊喜的变革?欢迎点赞并分享这篇文章,在评论区和大家交流你的观点。
